반도체_이온 주입(도핑)
우선 이온주입(Ion implantation)공정은 왜 하는지를 아는것부터 시작해야겠죠?
반도체에 대해 공부하시고 이 포스팅을 보고 계신분들이라면 도핑에 대해선 다들 알고 계실거라고 생각해서 도핑에 대해선 따로 자세하게 언급을 하지 않을게요
pure한 반도체는 Si으로 되어있어서 전기적 성질을 띄지 않기 때문에 반도체가 전기적 성질을 가질 수 있도록 불순물(dopant)를 넣어서 전도성을 갖게 해야합니다. 이러한 불순물을 미세한 가스입자로 만들어서 원하는 깊이만큼 웨이퍼 전면에 균일하게 넣어주는것을 이온주입공정 이라고 합니다.
Flow in Doping process
초기 - Thermal diffusion

출처 : https://angstromengineering.com/tech/chemical-vapor-deposition/diffusion-furnace/
산화공정과 비슷하게 열을 가해서 predeposition과 drive-in이라는 2개의 단계를 거쳐 dopant가 확산을 하여 도핑되는 공정으로 batch type이기 때문에 생산성이 높지만
1)소자가 scale down되면서 junction depth도 같이 scale down되었고 이에 shallow junction이 요구되었으며
2)두께가 얇아지면서 저항이 증가하자 채널 영역의 저항을 낮춰주기 위해서 heavy doping이 요구되었습니다
하지만 기존의 방식으론 이러한 요구들을 충족시키기 힘들어졌습니다.
현대 - Ion implantation

출처 : https://www.manufacturingguide.com/en/ion-implantation
확산공정으론 앞서말한 산업의 요구를 충족시킬 수 없었기 때문에 더 발전된 방식의 도핑공정이 요구되었는데요 이에 발전된 방식이 원하는 위치에 원하는만큼 도핑을 할 수 있는 이온주입공정이며 physical method입니다.
이온을 목표물의 표면을 뚫고 들어갈 만큼 큰 에너지를 갖도록 전기장으로 가속하여 반도체 내부로 넣어주는 방식으로 도핑을합니다


왼 : thermal diffusion 오 : ion implantation
이온주입 장비
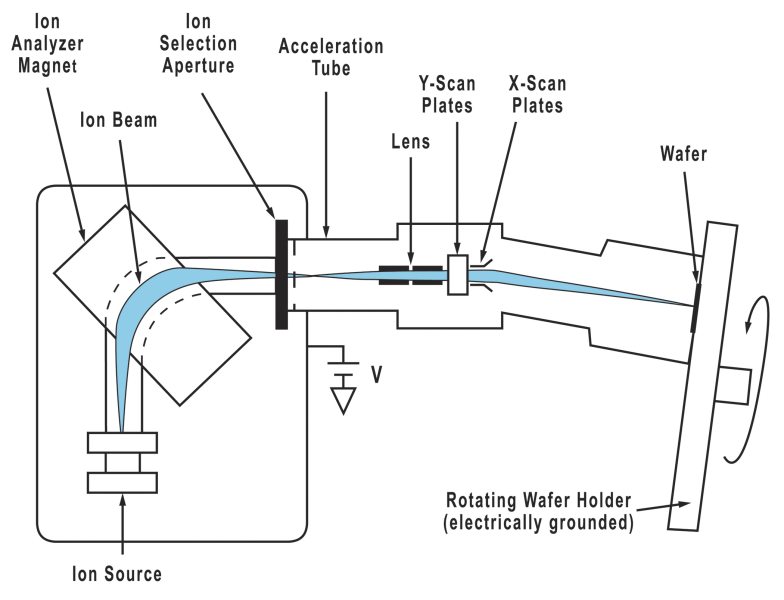
출처 : https://www.mksinst.com/n/ion-implantation
1) Ions generated in source : dopant gas를 넣어주고 강한 filed를 걸어줘서 ion으로 만듭니다
2) Select : source ion들이 자기장이 걸어진 영역을 지나가면 ion마다 다른 경로를 갖습니다. 이 경로는 이온의 질량과 관련이 있기 때문에 선택적으로 이온을 뽑아쓸 수 있습니다.
3) Accelerated : accelerator에서 원하는 속도를 갖도록 electric field를 통해 ion을 가속시킵니다.
4) Focused : 전기장을 이용하기 위해 glass가 아니라 electrostatic lenses를 사용합니다
5) impact substrate : 좌우로 움직이면서 wafer를 scanning하며 implant합니다. 이렇게 들어온 beam current의 양을 faraday cup를 이용해 측정하여 원하는 dose양에 이르면 주입이 완료됩니다.
또 이온주입 장비는 용도에 따라 다양한데요 전문적으로 배우지 않아서 간단하게 언급만 하고 넘어갈게요
1) medium current implanter : threshold adjust를 implant할때와 같이 낮은 dose가 필요할때 사용합니다.
2) high current implanter : source/drain을 implant할때와 같이 높은 dose가 필요할때 사용합니다.
3) high energy implanter : implant하는 ion의 에너지가 커야할때 사용합니다
4) low energy implanter : implant하는 ion의 에너지가 작을때 사용합니다